贺利氏电子-宋建波
摘要:
半导体封装技术总体上可以分为两大类: (1) Wire Bonding 引线键合工艺,(2) Non-Wire Bonding 非键合工艺,如FC、Clip bond等封装技术。据相关数据统计,使用引线键合这种传统封装工艺的器件仍占据近70%的出货量。虽然近些年来以WLCSP为代表的先进封装技术发展迅速,但传统的封装工艺不会被完全淘汰,两者会长期共存发展。
谈到半导体封装就不得不提到其重要的封装材料—键合线。目前市场上的键合线根据材质分为几大类:金、银、铜、镀钯铜、铝等。这几类线材已得到了广泛应用,这里就不过多赘述,我们就谈谈最新一代的键合线产品—镀金银线。
1 键合线市场信息:
由于黄金具有出色的抗氧化、抗腐蚀能力,及良好的电特性等优点, 被广泛的用于半导体封装中,早期的封装工艺使用的键合线只有金线。但随着黄金价格的不断攀升,在单颗器件中,金线的成本仅次于基板位居第二位(芯片除外),成为封装厂降低成本的主要目标。此时,铜线、镀钯铜线、银合金线等低成本的材料先后被推向市场,在各自的应用领域占据了一定市场份额。
下图为不同键合线的市场用量分析和预测:


2 为何是镀金银线?
目前金线的主要应用领域为存储器、高可靠性汽车电子、高端LED、摄像头模组、军工、航空等,这些领域里的产品由于其产品特点决定了不适合使用铜线、银合金线等低成本线材。
为何不能用铜线?由于铜线的硬度比金线高了约25%左右,在一些Pad铝层较薄的产品中,如存储器中Nand Flash有的薄至0.5um,如果打铜线很容易出现Pad Peeling、Crack等问题。相反,有部分产品Pad 铝层较厚,甚至达到4um以上,如果Pad焊点开窗较小,铝层飞溅将是铜线键合的主要挑战。
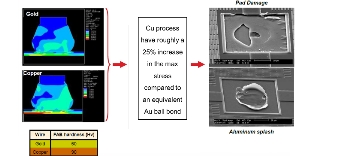
图1.铜与金对比,数据来源:贺利氏电子
为何不能用银合金线?由于银离子相对比较活跃,尤其在一些高湿的环境中,会产生银离子迁移的情况。同时,在有电流通过的情况下,银离子迁移速率会提高。银离子迁移会导致两个Pad之间短路,最终导致产品失效,尤其是在一些小间距产品上的挑战很大。此外,银容易与硫反应生成硫化银,从而产生可靠性问题。
通常我们在纯银里会参杂一些微量元素以改善上述性能,金(Au)、钯(Pd)常常被选为主要参杂元素。钯会形成氧化钯层从而抑制银离子析出的速度,金会减少自由的银离子的数量从而减少银离子迁移。
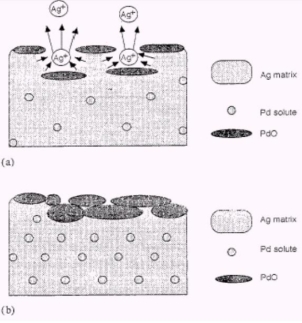
图2. PdO 层抑制银离子析出,图片来源: Kim Vu, Silver Migration – The Mechanism and Effects on Thick-Film Conductors, Material Science Engineering 234 – Spring 2003.
以下是不同纯度的银合金线的银迁移速率的对比。虽然合金会延缓银离子迁移速率,但在一些高湿度的可靠性测试中,银合金线表现出的可靠性还是比金线要差。所以,银合金线通常会在一些低可靠性要求的产品中才有应用。

图3.银离子迁移实验,数据来源:贺利氏电子
针对以上铜线、银合金线产品的不足之处,镀金银线被认为是目前这部分金线产品理想的替代品。它具体有哪些优势呢,下面会详细介绍一下。
3 镀金银线的特点:
在介绍产品特性前,先了解一下它的加工过程。顾名思义,镀金银线是在银外面电镀一层金,以下是镀金银线简单的生产工艺流程图:

图4. 镀金银线工艺流程图
核心材料为Ag加入少量Pd,Pd的添加可有效延缓IMC的生长,从而提高了高温存储的可靠性。
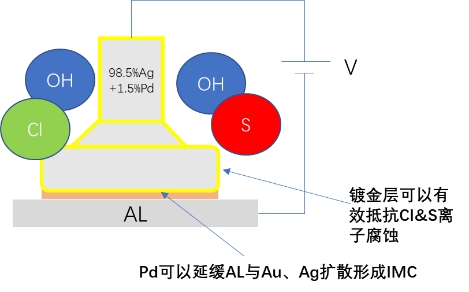
图5. 反应机理示意图
为何选择Au作为镀层材料?众所周知,金具有非常出色的抗氧化、抗腐蚀的特性,并与很多材料都有着良好的结合效果。因此,电镀一层金,对里面的银起到了很好的保护作用,从而提升了银线的抗硫化和抗腐蚀能力,也改善了银离子迁移的问题,提高了可靠性。
但是,由于Au与Ag 的材料属性决定了它们之间易融合从而相互扩散形成固容体,影响Au的表面覆盖率。所以,提高Au在Ag表面的覆盖率对于此类镀金银线的可靠性尤为重要。为了解决这个问题,通常会在Au与Ag之间加入阻碍层以延缓Au扩散到Ag内部。
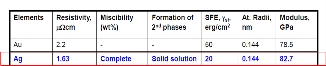
图6. Au &Ag 材料属性对比,数据来源:贺利氏电子
FAB抗氯离子腐蚀对比实验结果表明,与银合金线相比,镀金银线有着非常出色的抗氯离子腐蚀的性能,这是因为FAB表面Au包覆性非常好。为何会有如此好的包覆性?这也是得益于阻碍层起到了作用,减少了Au向融化后的银球里扩散。另外,电镀时特殊的添加物会使Au 具有良好的表面张力及润湿性,在FAB 形成时会更多的Au流下来覆盖FAB。
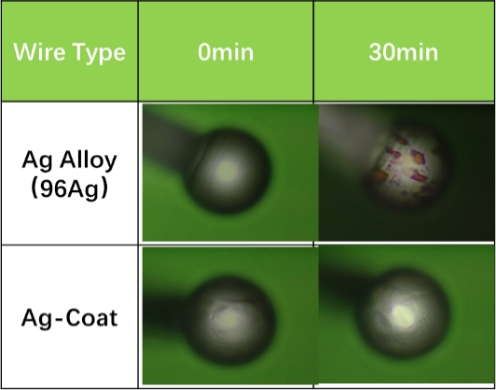
图7. FAB抗氯腐蚀实验
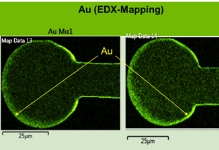
图8. FAB表面 Au 覆盖
在FAB形成时,除金线外其它材料都需要惰性气体进行保护,从而对设备提出了更高的要求。但实验结果显示,镀金银线加了保护气后FAB反而会变差,这是由于气体破坏了Au Flow的流动,使Au 分布变差,所以,这款镀金银线的键合工艺无需保护气体,真正实现了Gas Free,降低了对设备的要求。
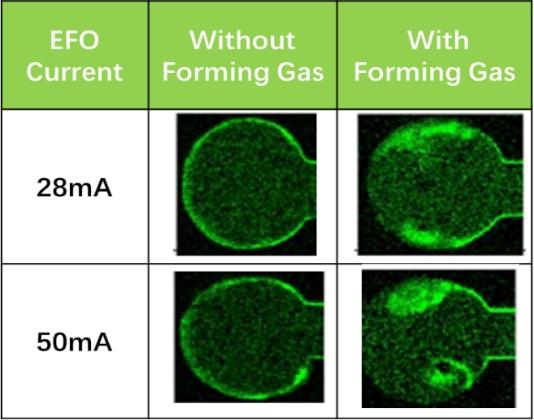
图9. FAB有/无保护气体对比
第一焊点与金线进行对比,球形很圆,特别适合小焊盘产品的使用;但由于镀金银线硬度会略高于金线,所以,在铝飞溅控制方面会略逊色于金线。
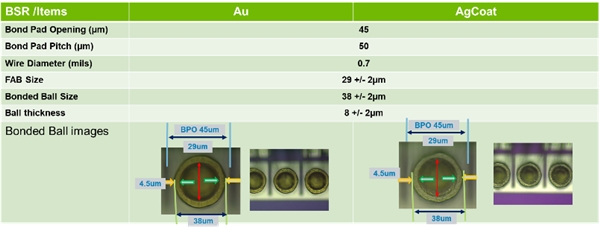
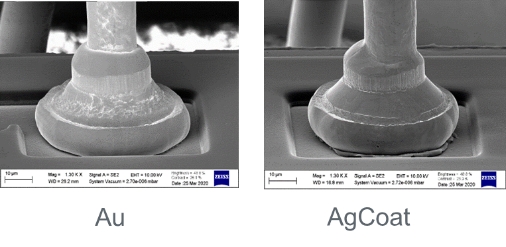
图10. 第一焊点球形对比
第二焊点与金线及其它银合金线进行对比,拉力值无显著差异;第二焊点参数窗口与金线基本重合,明显大于银合金线。

图11. 第二焊点拉力值对比
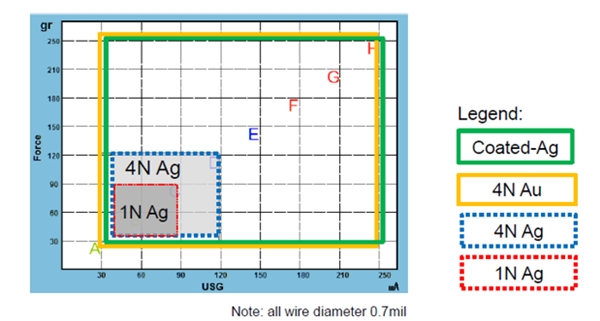
图12. 第二焊点参数窗口对比
可靠性测试,镀金银线在bHAST 196h,高低温循环2000次后,第一焊点切片结果显示Au层的覆盖没有被破坏,仍能起到很好的保护作用,另外,在高温存储3000小时后没有发现明显的柯肯达尔空洞现象。
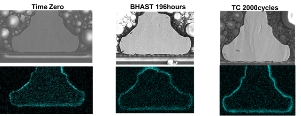
图13. EDS-Mapping图片
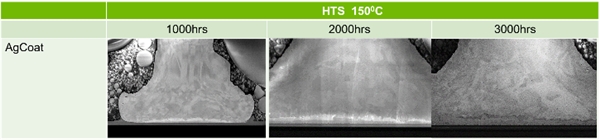
图14. 高温存储后切片照片

图15. 量产中的产品可靠性数据
以下是镀金银线与金线、银合金及铜线的对比。这里汇总了一些关键的性能指标,包括导电阻率与4N金线相当,FAB硬度远低于铜线,打开真空包装后的使用寿命是60天等。

4 镀金银线的主要推广领域:
![]()
做为贺利氏全球首推,第一款用于高端产品应用的镀金银线 AgCoatPrime,目前在存储器市场-NAND /NOR Flash、智能卡等市场已经有不少客户在量产使用。另外,在LED市场的室内/户外照明、摄像头、射频器件等消费类电子中的应用也在积极推广中。贺利氏依托其在键合线领域近50年的技术积淀,提供具有高可靠性和性价比的创新产品,与客户一同推动半导体封装技术的不断进步。






