为求技术突破,三星不只专注IC制程发展,更着眼于先进的IC封测,现阶段已开发出FOPLP(面板级扇出型封装)技术,试图提升自身先进封装能力,而FOPLP技术将与台积电研发的InFO-WLP(扇出型晶圆级封装)技术于未来Apple手机处理器订单中,一较高下。
先进封装技术的持续精进,使IC制造商竞争力大幅提升
针对三星 FOPLP与台积电InFO-WLP的技术比较,最大不同在于封装尺寸的大小差异,若依现行晶圆尺寸,InFO-WLP技术最大只能以12寸大小为主,但该技术却可透过垂直堆栈方式,将芯片整合于PoP(Package on Package)型式,强化整体元件的功能性。
而三星的FOPLP技术则是另一种思考模式,先将晶圆上的芯片切割好后,再置于方型载板中进行封装,而方型载板的面积最大为24寸×18寸,FOPLP技术将使整体封装数量大幅提升,并有效缩减成本。
在此竞争局面下,三星于半导体封装领域也积极布局,投入资源开发FOPLP技术,试图提升自身的先进封装能力,使其能与台积电技术相抗衡。
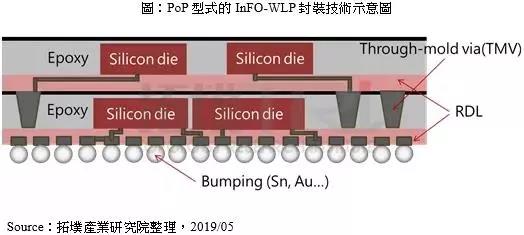
三星痛定思痛开发FOPLP技术,再次迎战2020年Apple手机处理器订单
三星开发FOPLP技术的原因,主要是2015年与台积电共同竞争Apple手机处理器订单失利所致。
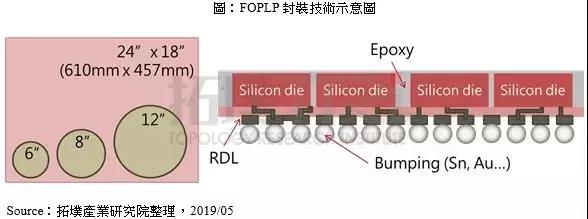
当时台积电除了IC制程优势外,在封装技术方面,因自身拥有InFO-FOWLP技术,在竞争中脱颖而出,取得至2020年为止Apple手机处理器的独家生产订单。在这样的失利情况下,三星痛定思痛,决定在2015年成立特别工作小组,目标开发先进封装FOPLP技术,且2018年正式应用于三星智能型手表Galaxy Watch的处理器封装应用中。

然而,三星虽有FOPLP技术的初步成果,但由于该封装技术仍有部分改进空间(芯片对位、填充良率等问题),后续三星 IC制程将搭配FOPLP封装技术,再次挑战2020年Apple手机处理器的代工订单。






